XRD应用介绍-单晶外延薄膜高分辨XRD表征
 发表时间:2023-02-03
发表时间:2023-02-03  浏览次数:11640
浏览次数:11640  作者:伦琴实验室
作者:伦琴实验室高分辨率 X 射线衍射 (HRXRD) 是一种强大的无损检测方法,其研究对象主要是单晶材料、单晶外延薄膜材料以及各种低维半导体异质结构。广泛用于单晶质量、外延薄膜的厚度、组分、晶胞参数、缺陷、失配、弛豫、应力等结构参数的测试。现代HRXRD与常规XRD的区别主要体现在:(1)高度平行且高度单色的高质量X射线;(2)不仅要测试倒易格点的位置(角度),还要测试倒易格点的形状(缺陷);(3)更高的理论要求-动力学理论。GaN做第三代半导体,目前用于电力电子、高频器件和发光二极管 (LED) 技术等众多应用中。本报告介绍了HRXRD在
GaN LED样品中的应用。样品由 6 层InGaN/GaN 量子阱 (QW) 组成,虚拟 GaN 衬底上生长在 2 英寸蓝宝石晶片上。文中样品测试是在德国布鲁克D8 ADVANCE X射线衍射仪上完成的,该仪器配置了HRXRD模块。
2theta/omega扫描
2theta/omega扫描用于探测平行于表面的原子层的相干散射,可用于确定In的组分,面外晶胞参数、厚度等参数。
测试采用Ge(004)单色器,林克斯探测器0D模式。图 1 显示了 GaN (0002) 晶面的 2theta/omega 扫描图谱,可见明显的
超晶格荡峰以及超晶格峰之间的薄膜干涉条纹。

图 1 GaN (0002) 晶面的 2theta/omega扫描图谱。
倒空间强度分布(RSM)
RSM是直观的分析薄膜与衬底失配关系以及薄膜缺陷的方法。传统的HRXRD上收集一张RSM需要几个甚至几十个小时。
现实中往往由于机时的限制,很难得到RSM。现代HRXRD利用1D探测器可以极大提高了测试速度,快采集一张RSM只需要几十秒。图2中,展示了GaN (11-24)晶面的RSM,测试时间为30min。
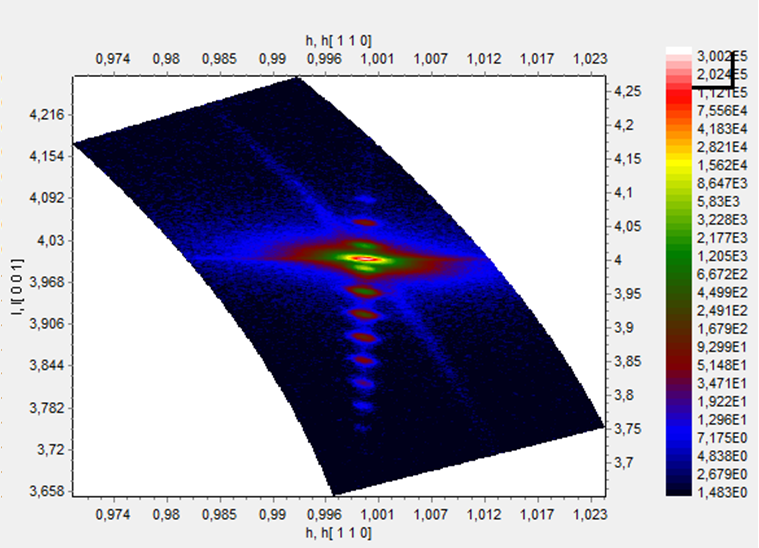
图2 GaN(11-24) 晶面的倒空间强度分布图(RSM)
图2中,RSM 中所有倒格点在面内((110)方向)方向在同一位置,表明量子阱多层膜InGaN是在 GaN 衬底上共格晶生长的。 这与GaN (0002) 晶面高质量2theta/omega扫描一致。同时,RSM中GaN倒格点形沿着面内展宽,说明界面处缺陷较多。而每个超晶格倒格点无明显展宽,说明超晶格之间缺陷较少。
2theta/omega 图谱拟合结果

图3 GaN (0002) 2theta/omega扫描拟合图谱。蓝色:拟合值;黑色:测试值。
图3中是 基于表1中的结构模型,对2theta/omega扫面进行全谱拟合的结果。可见拟合图谱与测试数据吻合非常好。超晶格峰与拟合值之间的微小偏差可能是由采用的拟合模型未考虑In组分的变化。InGaN 层中的超晶格厚度和In含量都可以非常精确地确定。In的含量是生长过程中的一个重要参数。 因此,HRXRD 是监控沉积过程的有力工具。

表1 GaN (0002) 2theta/omega扫描拟合模型及结果
d2 phaser d8 advance
Copyright © 束伦(上海)技术服务有限公司 All Rights Reserved 备案号:沪ICP备20020996号-1
技术支持:化工仪器网 管理登录 sitemap.xml

 退出
退出





