XRD应用介绍-X射线反射率
 发表时间:2023-12-06
发表时间:2023-12-06  浏览次数:15121
浏览次数:15121  作者:伦琴实验室
作者:伦琴实验室引言
作为一种非破坏性的表面敏感技术,X 射线反射率(XRR)广泛用于薄膜厚度和粗糙度的表征。 当X射线的入射角高于临界角时,X 射线束可以部分地透射进薄膜从而在界面反射。在一个理想平面上,根据菲涅耳方程,X射线的反射率以系数下降。此外,反射强度也受薄膜表面和界面的粗糙度影响。纳米尺度范围的粗糙表面可因诱导的漫散射而进一步降低反射强度。 因此,可以通过拟合XRR曲线来确定薄膜表面和界面的粗糙度。同时,表面和界面反射光束之间的干涉会在XRR曲线上产生周期性振荡,即所谓的 Kiessig 条纹。通过测定振荡周期可以计算薄膜的厚度,此外,散射长度密度(SLD)反映了材料的散射能力,与材料的物理密度有关。在 XRR 测量中,SLD 可以影响薄膜的全反射临界角以及Kiessig条纹的振荡幅度。通过拟合XRR曲线,可以直接给出分层结构的密度对比。图1中给出了图 XRR曲线与薄膜结构参数关系。本文以不同结构的薄膜为例,展示XRR在薄膜材料结构分析中的应用。

XRR的特点:
1. 无损检测
2. 对样品的结晶状态没有要求,不论是单晶膜、多晶膜还是非晶膜均可以进行测试
3. XRR适用于纳米薄膜,要求厚度小于200nm
4. 晶面膜,表面粗糙度一般不超过5nm
5. 多层膜之间要求有密度差
单层膜分析-样品:80nmIZO/玻璃(衬底)
本例中IZO薄膜的设计厚度时80nm,通过XRR曲线拟合得到实际的薄膜厚度为73.18nm,如图2所示。
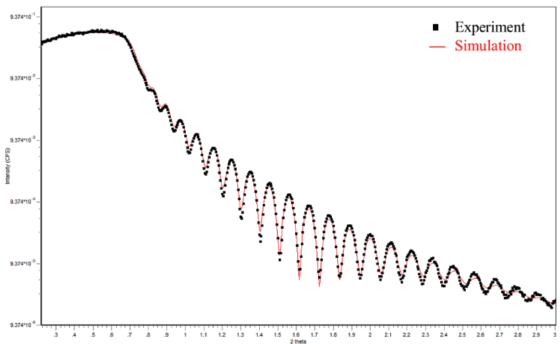
图2 IZO薄膜XRR曲线(红色点),拟合曲线(蓝色实线)以及结果(右上角)
多层膜分析-样品:Cu/Ta/Si(衬底)
XRR测试准确确定了各层薄膜的结构参数。表层Cu2O是的Cu层氧化导致的。

图3 Cu/Ta/Si(衬底)多层膜XRR曲线(红色点),拟合曲线(蓝色实线)以及结果(右上角)
超晶格
本例中,目标为Si/x(W/Si)/Si(衬底),x=10超晶格薄膜。为了确定生长后,超晶格的周期及重复单元单层的生长情况,利用XRR进行了表征,如图3。XRR曲线中,超晶格卫星峰和卫星峰间的干涉峰非常明显且均匀,说明超晶格薄膜生长均匀,质量很好。 不过,仔细观察超晶格曲线发现(图4):x=10个周期的超晶格,理论上两卫星峰之间的干涉条纹周期为x-2=8个极大值,但实际测得只有7个极大值。说明超晶格周期为9,而非理论上的10个周期。为了进一步证明和分析超晶格的结构,根据动力学理论,分别用理论的10个周期及实际分析出的9个周期结构模型拟合XRR曲线,9个周期的模型得到了很好的结果,见表1。说明超晶格表层没有生长为完美的周期结构。见表1。说明超晶格表层没有生长为完美的周期结构。

图4 中5.7-7.6°范围的放大图谱

表1 XRR拟合结果

图5 超晶格XRR曲线:黑色点:实验曲线;红色实线:拟合曲线。
Copyright © 束伦(上海)技术服务有限公司 All Rights Reserved 备案号:沪ICP备20020996号-1
技术支持:化工仪器网 管理登录 sitemap.xml

 退出
退出





